石英介紹

水熱法生長流程
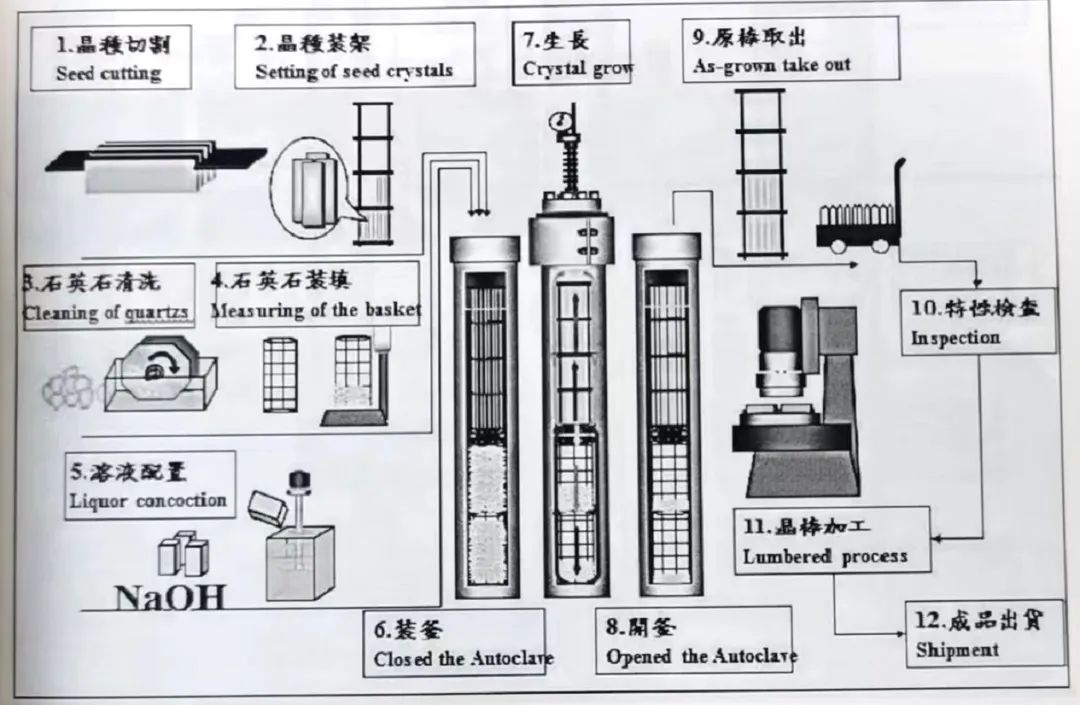
1 晶種切割 Seed cutting
2 晶種裝架 Setting ofseed crystals
3 石英石清洗 Cleaning ofquartzs
4 石英石填裝 Measuringof the basker
5 溶液配置 Liquorcollcoction
6 裝釜 Closed theautoclave
7 生長 Crystal grow
8 開釜Open theautoclave
9 原棒取出 As-growntake out
10 特性檢查 Inspection
11 晶棒加工 Lumberedprocess
12 成品出貨 Shipment
長晶釜構(gòu)造

低腐蝕隧道密度人工水晶生長養(yǎng)成

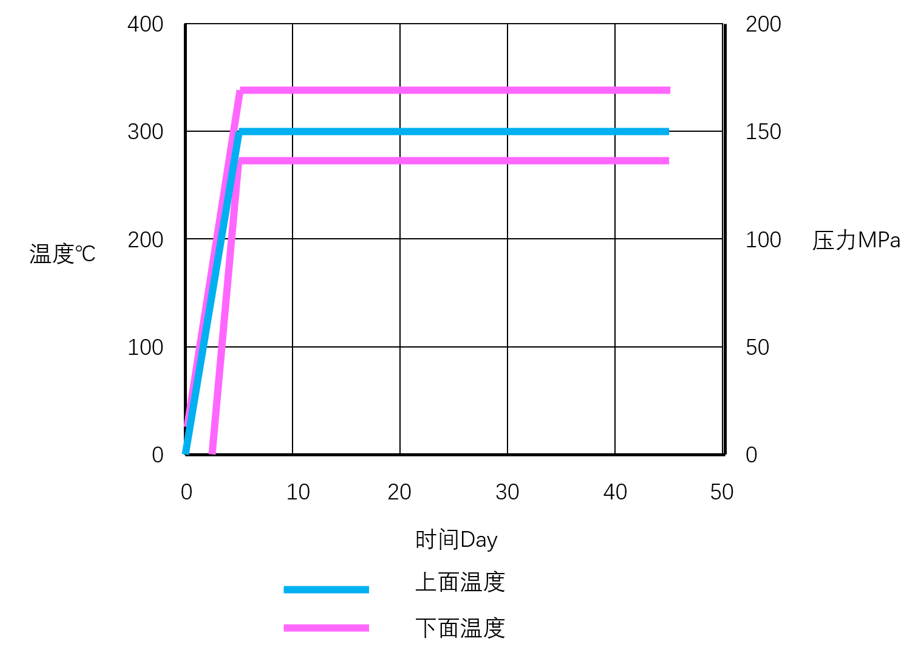
人工水晶種類
人造石英 ArtificialQuartz
光學(xué)棒 Quartzcrystal bars for optical use
壓電一般原棒 Quartzbars for crystal units
SAW原棒Quartz crystal bars for ST-cut
低腐蝕隧道密度及抗輻射晶體生長工序流程圖

聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
晶體
+關(guān)注
關(guān)注
2文章
1435瀏覽量
37614 -
石英
+關(guān)注
關(guān)注
0文章
41瀏覽量
18316
發(fā)布評論請先 登錄
相關(guān)推薦
熱點推薦
晶圓工藝制程清洗方法
晶圓工藝制程清洗是半導(dǎo)體制造的核心環(huán)節(jié),直接決定芯片良率與器件性能,需針對不同污染物(顆粒、有機物、金屬離子、氧化物)和制程需求,采用物理、化學(xué)、干法、復(fù)合等多類技術(shù),適配從成熟制程到先進(jìn)制程的全

晶圓去膠工藝之后要清洗干燥嗎
在半導(dǎo)體制造過程中,晶圓去膠工藝之后確實需要進(jìn)行清洗和干燥步驟。以下是具體介紹:一、清洗的必要性去除殘留物光刻膠碎片:盡管去膠工藝旨在完全去除光刻膠,但在實際操作中,可能會有一些微小的光刻膠顆粒殘留

12寸晶圓的制造工藝是什么
12寸晶圓(直徑300mm)的制造工藝是一個高度復(fù)雜且精密的過程,涉及材料科學(xué)、半導(dǎo)體物理和先進(jìn)設(shè)備技術(shù)的結(jié)合。以下是其核心工藝流程及關(guān)鍵技術(shù)要點: 一、單晶硅生長與晶圓成型 高純度多
【新啟航】玻璃晶圓 TTV 厚度在光刻工藝中的反饋控制優(yōu)化研究
一、引言
玻璃晶圓在半導(dǎo)體制造、微流控芯片等領(lǐng)域應(yīng)用廣泛,光刻工藝作為決定器件圖案精度與性能的關(guān)鍵環(huán)節(jié),對玻璃晶圓的質(zhì)量要求極為嚴(yán)苛 ??偤穸绕睿═TV)是衡量玻璃晶圓質(zhì)量的重要指

半導(dǎo)體行業(yè)案例:晶圓切割工藝后的質(zhì)量監(jiān)控
晶圓切割,作為半導(dǎo)體工藝流程中至關(guān)重要的一環(huán),不僅決定了芯片的物理形態(tài),更是影響其性能和可靠性的關(guān)鍵因素。傳統(tǒng)的切割工藝已逐漸無法滿足日益嚴(yán)苛的工藝要求,而新興的激光切割技術(shù)以其卓越的

晶圓制造中的退火工藝詳解
退火工藝是晶圓制造中的關(guān)鍵步驟,通過控制加熱和冷卻過程,退火能夠緩解應(yīng)力、修復(fù)晶格缺陷、激活摻雜原子,并改善材料的電學(xué)和機械性質(zhì)。這些改進(jìn)對于確保晶圓在后續(xù)加工和最終應(yīng)用中的性能和可靠性至關(guān)重要。退火

晶圓清洗工藝有哪些類型
晶圓清洗工藝是半導(dǎo)體制造中的關(guān)鍵步驟,用于去除晶圓表面的污染物(如顆粒、有機物、金屬離子和氧化物),確保后續(xù)工藝(如光刻、沉積、刻蝕)的良率和器件性能。根據(jù)清洗介質(zhì)、

晶圓蝕刻擴(kuò)散工藝流程
晶圓蝕刻與擴(kuò)散是半導(dǎo)體制造中兩個關(guān)鍵工藝步驟,分別用于圖形化蝕刻和雜質(zhì)摻雜。以下是兩者的工藝流程、原理及技術(shù)要點的詳細(xì)介紹:一、晶圓蝕刻工藝

晶圓切割中淺切多道工藝與切削熱分布的耦合效應(yīng)對 TTV 的影響
一、引言
在半導(dǎo)體晶圓制造領(lǐng)域,晶圓總厚度變化(TTV)是衡量晶圓質(zhì)量的關(guān)鍵指標(biāo),直接影響芯片制造的良品率與性能。淺切多道工藝通過分層切削降低單次切削力,有效改善

晶振常見封裝工藝及其特點
常見晶振封裝工藝及其特點 金屬殼封裝 金屬殼封裝堪稱晶振封裝界的“堅固衛(wèi)士”。它采用具有良好導(dǎo)電性和導(dǎo)熱性的金屬材料,如不銹鋼、銅合金等,將晶振芯片嚴(yán)嚴(yán)實實地包裹起來。這種封裝

晶圓減薄工藝分為哪幾步
“減薄”,也叫 Back Grinding(BG),是將晶圓(Wafer)背面研磨至目標(biāo)厚度的工藝步驟。這個過程通常發(fā)生在芯片完成前端電路制造、被切割前(即晶圓仍然整體時),是連接芯片制造和封裝之間的橋梁。
提供半導(dǎo)體工藝可靠性測試-WLR晶圓可靠性測試
隨著半導(dǎo)體工藝復(fù)雜度提升,可靠性要求與測試成本及時間之間的矛盾日益凸顯。晶圓級可靠性(Wafer Level Reliability, WLR)技術(shù)通過直接在未封裝晶圓上施加加速應(yīng)力,實現(xiàn)快速
發(fā)表于 05-07 20:34
晶圓制備工藝與清洗工藝介紹
晶圓制備是材料科學(xué)、熱力學(xué)與精密控制的綜合體現(xiàn),每一環(huán)節(jié)均凝聚著工程技術(shù)的極致追求。而晶圓清洗本質(zhì)是半導(dǎo)體工業(yè)與污染物持續(xù)博弈的縮影,每一次工藝革新都在突破物理極限。

晶圓高溫清洗蝕刻工藝介紹
晶圓高溫清洗蝕刻工藝是半導(dǎo)體制造過程中的關(guān)鍵環(huán)節(jié),對于確保芯片的性能和質(zhì)量至關(guān)重要。為此,在目前市場需求的增長情況下,我們來給大家介紹一下詳情。 一、工藝原理 清洗原理 高溫清洗利用物理和化學(xué)的作用
晶圓濕法清洗工作臺工藝流程
晶圓濕法清洗工作臺是一個復(fù)雜的工藝,那我們下面就來看看具體的工藝流程。不得不說的是,既然是復(fù)雜的工藝每個流程都很重要,為此我們需要仔細(xì)謹(jǐn)慎,這樣才能獲得最高品質(zhì)的產(chǎn)品或者達(dá)到最佳效果。



 人工長晶工藝
人工長晶工藝




評論